Dispensing Technology of Low cost, High Efficiency and
Reliability for Packaging of Miniature Chips |
| patented technology |
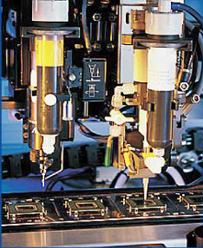 |
|
| About the invention patent |
The present invention patent relates to packaging methods using fluid resin. The fluid resin dispensing and packaging method of the present invention is suitable for packaging of bare semiconductor chips on a variety of module substrates and is characterized by low cost, high speed, efficiency, safety and reliability, and high esthetic appeal and regularity. It has wide applications and high commercial value, particularly suitable for mass production of semiconductor modules.
|
|
| Two technological innovations |
|
| 1. Low cost and high efficiency |
 It saves the barrier fabrication process required in conventional dispensing a fluid resin and for packaging therewith, reduces the area of the package to be occupied and greatly saves the time to package each semiconductor chip. It saves the barrier fabrication process required in conventional dispensing a fluid resin and for packaging therewith, reduces the area of the package to be occupied and greatly saves the time to package each semiconductor chip.
|
 Utilizing the necessary procedure of applying solder mask during the process of fabricating substrates, the solder mask is used to cover the peripheral boundary of the object to be packaged. A barrier serving to prevent the liquid resin from overflowing is formed by utilizing surface tension between the fluid resin and the solder mask. With the aid of the fluid resin barrier, the dispensed fluid resin can be contained within the range of the design. A clean and neat resin-packaged substrate can be obtained after the resin is solidified by heating the substrate. Utilizing the necessary procedure of applying solder mask during the process of fabricating substrates, the solder mask is used to cover the peripheral boundary of the object to be packaged. A barrier serving to prevent the liquid resin from overflowing is formed by utilizing surface tension between the fluid resin and the solder mask. With the aid of the fluid resin barrier, the dispensed fluid resin can be contained within the range of the design. A clean and neat resin-packaged substrate can be obtained after the resin is solidified by heating the substrate.
|
|
|
|
|
Fig.1 the conventional technology to fabricate barrier
|
|
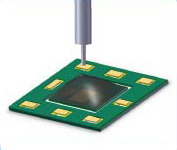 |
Fig.2 the technology of the present patent
|
|
| 2. Safety and reliability |
 The solder-escaping metal plate is disposed within the fluid resin barrier. The solder-escaping metal plate is disposed within the fluid resin barrier. |
The solder will flow outwardly because of over temperature or the self-heating of the working semiconductor. It might cause short circuit of the adjacent pins which are not connected by the same circuit. The solder can be led to secure area through the solder-escaping plate, thus it can prevent the false short circuit inside the chip or other failures that will damage semiconductor components.
|
 The solder ink-escaping space is disposed within the fluid resin barrier. The solder ink-escaping space is disposed within the fluid resin barrier. |
The solder ink will become inflated or gasified because of over temperature or the self-heating of the working semiconductor, which might cause the blast of the fluid resin. The solder ink-escaping space provides escaping space for the inflated and gasified solder ink, preventing the fluid resin from blasting due to over temperature, thus the failure rate is decreased and the reliability of the module is enhanced.
|
|
|
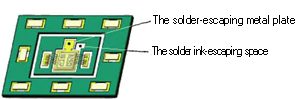 |
| Fig.1 the plane view of the substrate |
|
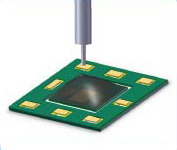 |
Fig.2 the cross sectional view of the substrate
|
|
| Competitive edge & commercial values |
 It decreases the cost and reduces the area of the package to be occupied. It decreases the cost and reduces the area of the package to be occupied. |
 The speed of the packaging is fast and the time to package each semiconductor chip is greatly reduced. The speed of the packaging is fast and the time to package each semiconductor chip is greatly reduced. |
 The production efficiency is increased and the cost is decreased, so it is suitable for mass production. The production efficiency is increased and the cost is decreased, so it is suitable for mass production. |
 The solder-escaping metal plate and the solder ink-escaping space are incorporated inside of the fluid resin barrier so as to decrease the failure rate and enhance the reliability. The solder-escaping metal plate and the solder ink-escaping space are incorporated inside of the fluid resin barrier so as to decrease the failure rate and enhance the reliability. |
 It does not influence the replacement and repair of components outside of the barrier so that the yield of the production is increased. It does not influence the replacement and repair of components outside of the barrier so that the yield of the production is increased. |
 It dispenses and packages a bare object directly and neatly on a substrate. It dispenses and packages a bare object directly and neatly on a substrate. |
 It is suitable for resin packaging of semiconductor chips It is suitable for resin packaging of semiconductor chips |
